HardZone – Cómo una tecnología puede cambiarlo todo: así es InFO de TSMC en CPU
![]()
Solemos mirar hacia delante, pero poco miramos hacia atrás. A veces hacer eso es más que conveniente para saber hacia dónde vamos y qué hemos aprendido, o simplemente para comprender por qué las cosas son así. En el mundo de las obleas, de sus interconexiones y paquetes, una tecnología generalista lo cambió todo, hasta el punto de que hoy en día se usan evoluciones de ella para crear desde procesadores de alto rendimiento, hasta SoCs móviles. Hablamos de InFO, una tecnología que fue desarrollada por TSMC.
Para que la evolución de los procesadores y chips se dé, se necesitan unas bases que determinen el rendimiento y las capacidades de las nuevas tecnologías que van a albergar. Aunque un ingeniero tenga en la cabeza cómo se deberían enfocar estos en los años venideros, la forma de llevarlo a cabo es el paso realmente complicado. Hemos visto como la industria vira hacia los chiplets, pero, aunque son una realidad que poco a poco se hace con el mercado, una te las tecnologías y conceptos clave es poco conocida. ¿Cómo hemos llegado hasta aquí?
InFO y sus dos variantes PoP y oS son la clave de la evolución
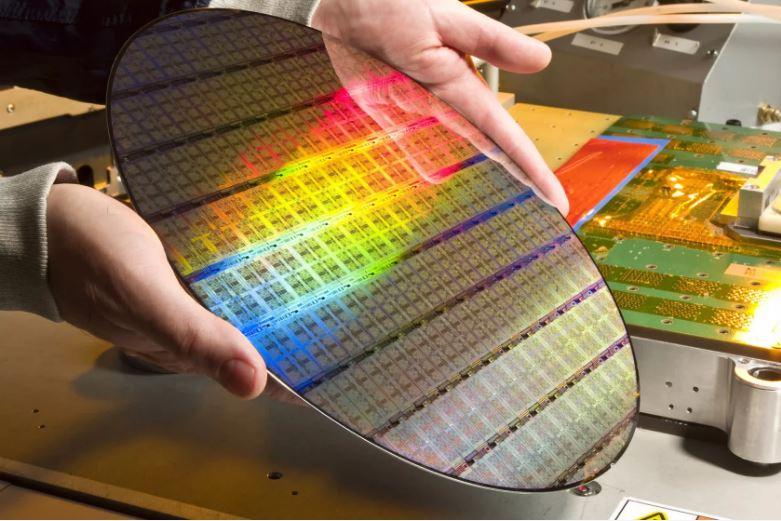
Antes de meternos de lleno en la tecnología en sí misma, debemos saber que es InFO. Como tal InFO es el acrónimo de Integrated Fan-Out, lo que se suele denominar en la industria como un envasado a nivel de oblea, que traducido llegaría como una plataforma de tecnología para la integración de sistemas.
Es decir, un método para agregar subsistemas o componentes a los chips ya dentro de la propia oblea. Un ejemplo claro es HBM dentro de cualquier chip en formato vertical (no horizontal como las GPUs que necesitan un sustrato o interposer, no hay que confundirlos) aunque nos valdría también cualquier tipo de DRAM, por ejemplo.
Para lograr integrar un subsistema o componente a nivel de oblea se necesitará usar RDL (Re-Distribution Layer) de alta densidad y además la tecnología TIV (Through InFO Via) para realizar las interconexiones entre ambas capas sin perder rendimiento. El proceso implica cortar los chips de una oblea de silicio y luego colocarlos con mucha precisión en una oblea delgada «reconstituida» o portadora, que luego se moldea. Se crea la capa de redistribución y luego se forman bolas de soldadura en la parte superior, como en un paquete de escala de chip a nivel de oblea. Tras eso, la nueva oblea formada por chips se hornea para que se cure el compuesto y ya estaría lista para su producción.
Las variantes implican poder diseñar chips 2D o 3D
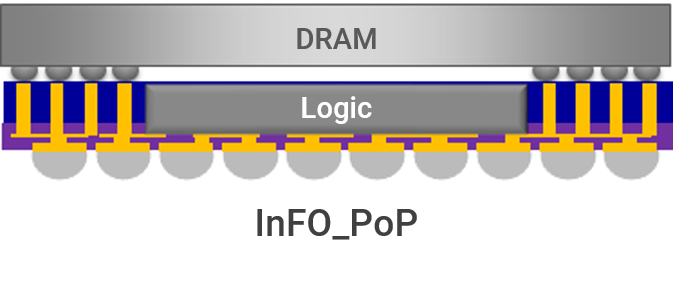
Como hemos comentado, InFO tiene dos variantes que, dependiendo del diseño del chip y su complejidad, pueden usarse para su creación en la oblea. Hablamos de PoP y oS, donde cada uno tiene sus particularidades y de momento y a pesar de que llevan usándose desde los 16 nm, ninguno termina de imponerse al otro como dominador claro.
InFO_PoP es el primer package Fan-Out para la industria dentro del concepto de oblea 3D. Es el más usado cuando se integra componentes como dies, DRAM o sustratos interpuestos para más capas. Tiene la particularidad de usar unas soldaduras más finas, lo que le confiere un perfil final más delgado y un mejor rendimiento eléctrico y térmico debido a que carece de sustrato orgánico.
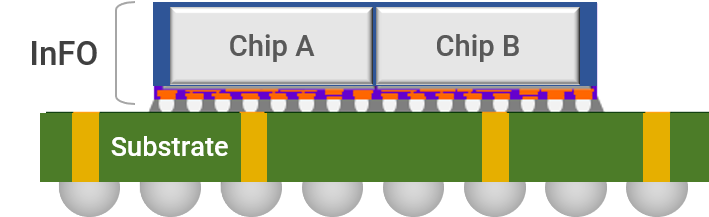
En cambio, InFO_oS sí que necesita de un sustrato para poder tomar forma, donde la altura normal será de 2 micrómetros aproximadamente. La ventaja es que al incluir sustrato se puede interconectar más chips con este y no depende de algo tan individualizado como es el método PoP. Dar medidas de E/S o input es complicado, puesto que cada compañía tiene las suyas propias y cada nodo requiere una redimensión de las mismas, pero en cualquier caso hablamos siempre de micrómetros.
Esta tecnología es la que ha permitido a Intel y TSMC postergar la Ley de Moore durante otros años más, aunque sea a base de escalar sistemas con múltiples obleas.
InFO-L/LSI, lo último para escalabilidad de sistemas
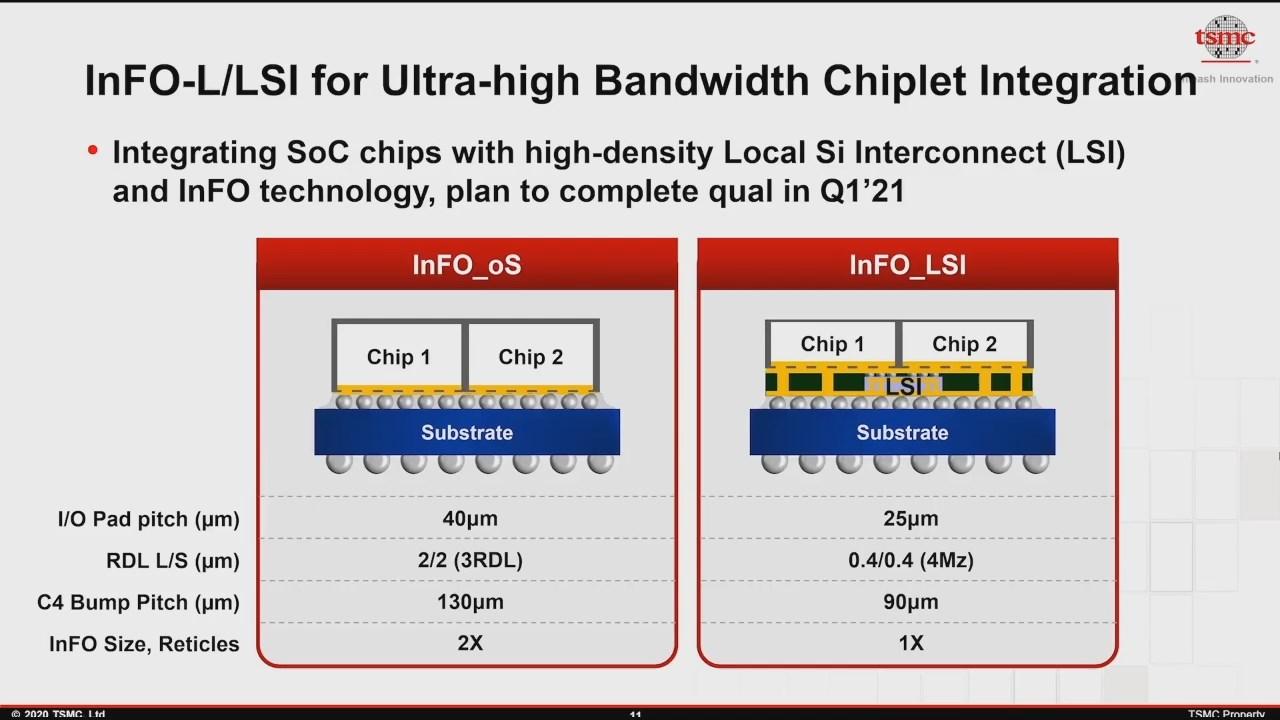
Una nueva técnica dentro de InFO debería estar a punto de terminarse para ser producido en masa ya en 2022. Hablamos de InFO-L o InFO_LSI, como se prefiera, donde entre el sustrato y los chips se integra una capa de interconexión de silicio que mejora aspectos como la integridad de las señales e incluso los voltajes o temperatura, puesto que requieren menores valores.
El problema es que los chips deben ser diseñados con un grosor inferior para no elevar demasiado la altura general del die, limitando térmicamente la disipación entre capas. Esto es interesante cuando se trata de los núcleos de GPU o CPU más HBM en cualquiera de sus variantes.
Añadir altura limita los valores máximos tolerables, como vimos por ejemplo en el i9-9900K o en las Radeon VII, así que no es algo a despreciar realmente. Los nuevos chips que salgan de fábrica tienen que lograr esto, así que será interesante comprobar cuánto suben con respecto al sustrato primigenio.
The post Cómo una tecnología puede cambiarlo todo: así es InFO de TSMC en CPU appeared first on HardZone.
